半导体产业概览
《存储器涨价的原因?》 说过对半导体产业并不了解。于是我们来简单看看半导体产业吧。
# 一、半导体产业
# 整体结构与市场份额
- 集成电路 81%
- 芯片IC(CUP/GPU) -3,401亿美元
- 存储器Memory(RAM/ROM/Flash Memory/FIFO/FILO) -1,229亿美元
- 可编程逻辑器件PLD,PLD的逻辑功能可以根据用户对器件的编程来决定,设计人员不用介入版图设计和生产流程,可以通过编程快速得到想要的电子系统功能。弥补版图设计的生产周期太长、高成本的问题。
- 模拟器件(变压器/音视频电路/电阻/电容),模拟信号是指在时域上数学形式为连续函数的信号。与模拟信号对应的是数字信号,后者采取分立的逻辑值,而前者可以获取连续值。
- 光电器件 10% -344.67 亿美元,指把光和电这两种物理量联系起来,使光和电互相转化的新型半导体器件。
- 分立器件 6%
- 传感器 3% -125亿美元
# 企业营收
 上图为2017 年 Q1 各大半导体厂商营收排名
上图为2017 年 Q1 各大半导体厂商营收排名
- 英特尔Intel
- 三星Samsung
- 海力士SK hynix
- 美光Micron
- 博通Broadcom
- 高通Qualcomm
- 德州仪器TI
- 东芝Toshiba
- 恩智浦NXP(被高通收购)

# 二、集成电路行业
目前有了两种主要业务模式,一种是IDM整合元件制造商(Integrated Device Manufacturer)模式,即一家公司覆盖集成电路全产业链,另一种是垂直分工模式,即 Fabless(fabless semiconductor company) + Foundry + 封测厂商。
- IDM就是指Intel和三星这种拥有自己的晶圆厂,能够一手包办IC设计、芯片制造、芯片封装、测试、投向消费者市场五个环节的厂商。
- 无厂半导体公司(Fabless)则是指有能力设计芯片架构,但是却没有晶圆厂生产芯片,需要找代工厂代为生产的厂商,知名的有 高通、ARM、苹果和华为。
- 代工厂(Foundry)则是无芯片设计能力,但有晶圆生产技术的厂商,代表公司是台积电、联电等。
- 封测厂商,就是专注于封装测试环节的公司,典型的有日月光、长电科技等。
半导体生产线成本非常高。由于半导体的生产线必须时刻保持其运转而不能根据订单多少轻易关停,这意味着如果没有足够的订单,生产线只能空转而造成极大的成本浪费。随着半导体业趋于接近摩尔定律的终点(物理极限),其研发、建设和运营成本迅速上升,此时代工厂技术和成本优势得到有效体现。受到Fabless盈利模式灵活、轻便和高利润率的启发,越来越多IDM厂诸如TI、Renesas、STM等纷纷转型FabLite(轻晶圆厂),即将部分生产和设计业务外包。
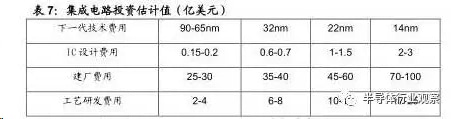

ICInsights数据显示0.13um制程时代全球有22家IDM厂。随着IDM朝轻晶圆厂发展趋势成型,IDM厂数量急遽减少,至45nm制程时代,全球IDM厂仅剩9家,迈入22/20nm制程将仅存英特尔及三星两家IDM。
Fabless模式使“轻资产重设计”的运营模式成为IC市场的主流趋势,较低的固定资产投资和灵活的企业战略以及低廉的运营成本使其保持较高的的业绩增速。从经营业绩角度来看,自1999年至2014年,fabless几乎始终保持高于IDM的营收增速,其中IDM的CAGR为3%,而fabless的CAGR为15%。
# 十大Fabless
- 博通Broadcom
- 高通Qualcomm
- 联发科MTK
- 英伟达NVIDIA
- 超威AMD
- 美满Marvell
- 赛思灵Xilinx
- 联咏Novatek
- 瑞昱Realtek
- Dialog
- 海思
# 国内几大Fabless
# 海思
中国IC设计龙头。海思半导体成立于2004年10月,前身是华为集成电路设计中心。海思的业务包括消费电子、通信、光器件等领域的芯片及解决方案,已成功应用在全球100多个国家和地区。经过数年的快速发展,海思半导体成长为中国本土最大的集成电路设计企业,2016年销售收入预计达39.78亿美元,排名中国TOP1,世界TOP50。
海思半导体的移动智能终端芯片全面应用于华为的整机产品,整体性能比肩国际的同类产品水平。与此同时,海思通过独立运作的商业模式,将逐步实现对外运营,供应非华为手机,发展成为一家专业、全球性的芯片供应商。

# 清华紫光展讯
展讯通信,聚焦手机芯片:展讯通信成立于2001年4月,始终致力于智能手机、功能型手机及其他消费电子产品的手机芯片平台开发,产品支持2G、3G及4G无线通讯标准。2014年展讯被紫光集团私有化后与锐迪科合并,变成了紫光的芯片事业部。 2015年展讯通信在全球移动芯片的出货量达5.3亿片,占全球基带芯片市场的22%,排在高通(38%)和联发科(26%)之后位列全球第三。回顾2011年,展讯全球移动芯片的出货量仅2.1亿,仅占全球基带芯片市场的10%。仅仅五年时间,展讯实现了芯片出货量250%的增长,从全球市占率10%迅速增长到22%。

# 集成电路生产流程
集成电路产业链可以大致分为电路设计、芯片制造、封装及测试三个主要环节。集成电路生产流程是以电路设计为主导,由集成电路设计公司设计出集成电路,然后委托芯片制造厂生产晶圆,再委托封装厂进行集成电路封装、测试,最后销售给电子整机产品生产企业,其中制造与封装过程中,需要利用许多高精设备和高纯度材料。

# 步骤一: IC设计
处于价值链的高端,毛利率高。
- 规格制定:客户向芯片设计公司提出的设计要求,包括芯片需要达到的具体功能和性能方面的要求。
- HDL编程:使用硬件描述语言(VHDL,VerilogHDL)将实际的硬件电路功能通过HDL语言描述出来模块功能以代码来描述实现。
- 逻辑综合:逻辑综合的结果就是把设计实现的HDL代码翻译成门级网络。
- 仿真模拟:仿真模拟检验编码设计的正确性,看设计是否精确地满足了规格中的所有要求。设计和仿真验证是反复迭代的过程,直到验证结果显示完全符合规格标准。
- 布线:即普通信号布线了,包括各种标准单元(基本逻辑门电路)之间的走线。
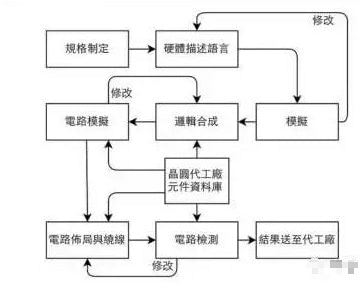
# IC设计产品领域
- 通信
- 智能卡
- 计算机
- 多媒体
- 导航
- 模拟
- 功率
- 消费电子
# IP
IP(IntellectualProperty)核是指集成电路设计中预先设计、验证好的功能模块,由于性能高、功耗低、技术密集度高、知识产权集中、商业价值昂贵,是集成电路设计产业的最关键产业要素和竞争力体现。随着SOC(SystemonChip,芯片级系统)的兴起,“购买IP核+自研SoC”已成为IC设计的主流模式,全球各企业对IP核的数量、质量和服务的需求不断增加。

# 步骤二: 半导体制造流程
晶圆制造
晶圆是制作硅半导体IC所用之硅晶片,状似圆形,故称晶圆。材料是「硅」, IC(Integrated Circuit)厂用的硅晶片即为硅晶体,因为整片的硅晶片是单一完整的晶体,故又称为单晶体。但在整体固态晶体内,众多小晶体的方向不相,则为复晶体(或多晶体)。生成单晶体或多晶体与晶体生长时的温度,速率与杂质都有关系。 普通硅沙(石英砂)-->纯化-->分子拉晶-->晶柱(圆柱形晶体)-->晶圆(把晶柱切割成圆形薄片)几个步骤。
- 石英砂纯化:第一步是冶金级纯化,此过程主要是加入碳,以氧化还原的方式,将氧化硅转换成98%以上纯度的硅。通过多步净化得到可用于半导体制造质量的硅,学名电子级硅(EGS),平均每一百万个硅原子中最多只有一个杂质原子。
- 分子拉晶:将前面所获得的高纯度多晶硅融化,形成液态的硅之后,以单晶的硅种和液体表面接触,一边旋转一边缓慢的向上拉起。最后,待离开液面的硅原子凝固后,排列整齐的单晶硅柱便完成了,其硅纯度达到99.999999%。
- 切割晶圆:用机器从单晶硅棒上切割下一片事先确定规格的硅晶片,这些硅晶片经过洗涤、抛光、清洁和接受入眼检测与机器检测,最后通过激光扫描发现小于人的头发丝宽度的1/300的表面缺陷及杂质,合格的圆晶片交付给芯片生产厂商。
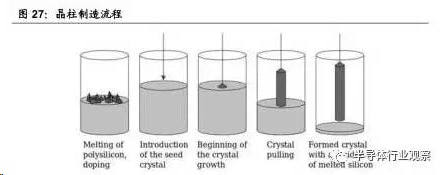
集成电路制造
集成电路制造工艺是由多种单项工艺组合而成的,简单来说有四个主要步骤:薄膜制备工艺;图形转移工艺和掺杂工艺。
薄膜制备工艺 薄膜制备工艺:集成电路的制造过程中需要在晶圆片的表面上生长数层材质不同,厚度不同的薄膜,制造膜层的主要方法有氧化,化学气相沉积(CVD)以及物理气象沉积(PVD)。 (1)氧化:硅晶圆片与含氧物质(氧气,水汽等氧化剂)在高温下进行反应从而生成二氧化硅膜。 (2)CVD:把一种或几种含有构成薄膜元素的化合物、单质气体通入放置有基材的反应室,借助空间气相化学反应在基体表面上沉积固态薄膜的工艺技术。
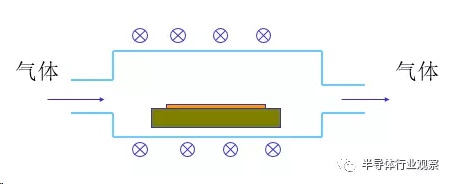 (3)PVD:采用物理方法,将材料源电离成离子,并通过低压气体或等离子体过程,在基体表面沉积具有某种特殊功能的薄膜的技术。
(3)PVD:采用物理方法,将材料源电离成离子,并通过低压气体或等离子体过程,在基体表面沉积具有某种特殊功能的薄膜的技术。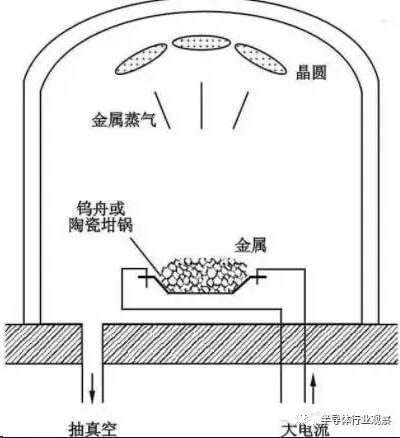
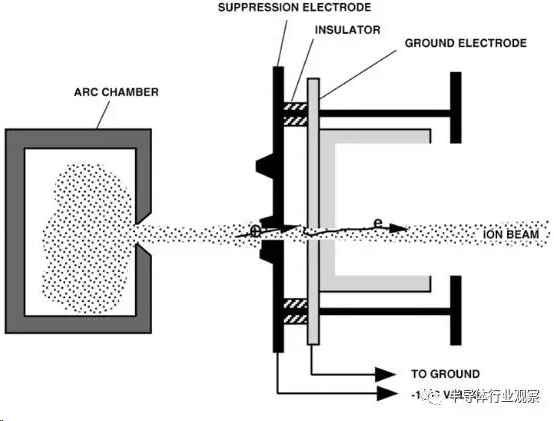
图形转移工艺 图形转移工艺:IC制作工艺中氧化,沉积以及扩散,离子注入等流程本身对晶圆片没有选择性,都是对整个硅晶圆片进行处理,不涉及任何图形。IC制造的核心是将IC设计者的要求的图形转移到硅晶圆片上,因此需要图形转移工艺,主要包括光刻工艺。 (1)光刻工艺:光刻是将掩膜板上的图形复制到硅片上,作为半导体最重要的工艺步骤之一,光刻的成本约为整个硅片制造工艺的1/3,耗费时间约占整个硅片工艺的40~60%。(1)在硅晶圆片上涂上光刻胶,用预先制作好的有一定图形的光刻掩膜版盖上。(2)对涂有光刻胶的晶圆片进行曝光,光刻胶感光后其特性发生改变,正胶的感光部分变得容易溶解,而负胶则相反。(3)对晶圆片进行显影。正胶经过显影后被溶解,只留下未受光照部分的图形,而负胶相反,收到光照部分变得不容易溶解。(4)经过显影后,对晶圆片进行刻蚀,将没有被光刻胶覆盖部分去除掉,达到将光刻胶上的图形转移到其下层材料上的目的。由于光刻胶的下层薄膜可能是二氧化硅,氮化硅,多晶硅或者金属材料,材料不同或者图形不同,刻蚀的要求也不同。(5)用去胶法把涂在晶圆片上的感光胶去掉。 关键技术参数:最小可分辨图形尺寸Lmin(nm) 、聚焦深度DOF;曝光方式:紫外线、X射线、电子束、极紫外光;
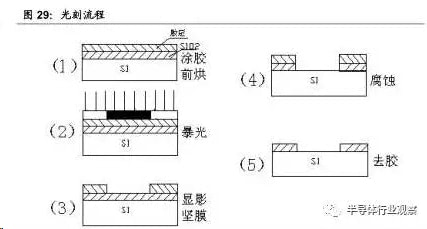
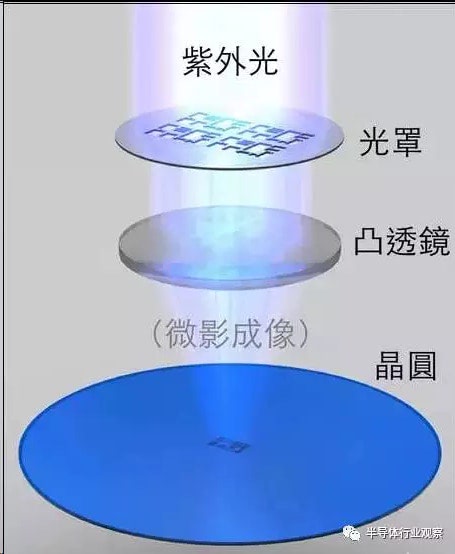
(2)蚀刻技术(Etching Technology): 是将材料使用化学反应物理撞击作用而移除的技术。可以分为:湿蚀刻(wet etching):湿蚀刻所使用的是化学溶液,在经过化学反应之后达到蚀刻的目的;干蚀刻(dry etching):干蚀刻则是利用一种电浆蚀刻(plasma etching)。电浆蚀刻中蚀刻的作用,可能是电浆中离子撞击晶片表面所产生的物理作用,或者是电浆中活性自由基(Radical)与晶片表面原子间的化学反应,甚至也可能是以上两者的复合作用。
掺杂工艺 掺杂工艺:掺杂工艺是将可控数量的所需杂质掺入晶圆的特定区域中,从而改变半导体的电学性能。扩散和离子注入是半导体掺杂的两种主要工艺。(1)扩散:扩散是一种原子,分子或离子在高温驱动下(900-1200℃)由高浓度区向低浓度区的运动过程,杂质的浓度从表面到体内单调下降,而杂质分布由温度和扩散时间来决定。(2)离子注入:在真空系统中,用经过加速,并掺杂原子的离子照射固体材料,从而在被注入的区域形成特殊的注入层,并 改变这些区域的硅的导电性。经过电场加速后,注入的离子流的速度可以超过30万千米每小时。
尽管芯片表面看起来异常平滑,但事实上包含20多层复杂的复合层电路,形如未来世界的多层高速公路系统。

进行晶圆测试:使用参考电路图案和每一块芯片进行功能性测试,然后丢弃瑕疵内核。
将晶圆切割成块,尺寸300毫米/12英寸,每一块就是一个处理器的内核(Die)。
# 步骤三: 封装
封装是保护芯片免受物理、化学等环境因素造成的损伤,将芯片的I/O端口联接到印制电路板(PCB)、玻璃基板等,以实现电气连接,确保电路正常工作的工艺步骤。测试主要是对芯片、电路以及老化后的电路产品的功能、性能测试。
封装工艺的基本流程为:硅片减薄、硅片切割、芯片贴装、芯片互连、成型技术、去飞边毛刺、切筋成型、上焊锡、打码等工艺。
封测业在集成电路产业链中,相对技术和资金门槛较低,属于产业链中的"劳动密集型"。
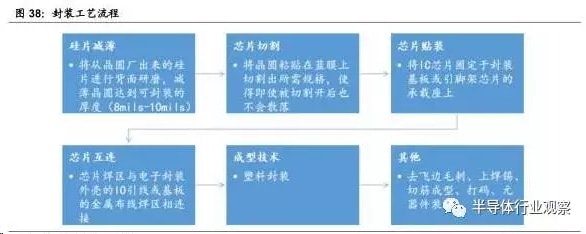
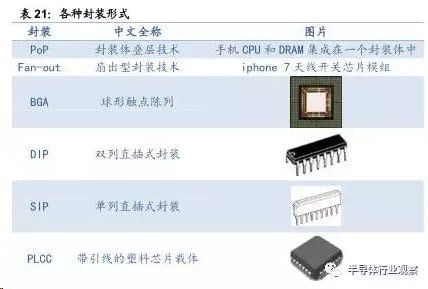
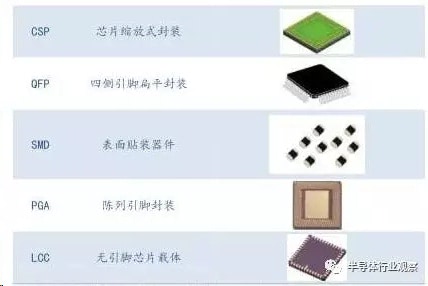
# 步骤四: 成品测试
测试集成电路。可以鉴别出每一颗处理器的关键特性,比如最高频率、功耗、发热量等,并决定处理器的等级。

# 集成电路生产设备


# 三、芯片IC
- FPGA(赛灵思Xilinx/英特尔Intel)
- 中央处理器CUP(英特尔Intel/超威AMD/高通Qualcomm/苹果apple)
- 图形处理器GPU(英伟达NVIDIA/AMD(ATI)/Imagination/高通Qualcomm/ARM/Vivante)
CUP与GUP的区别在于处理的问题不一样。CUP是设计的时候就是为处理所有的问题而设计的集成电路。图形处理量越来越大因此需要一个效率更高的处理器就诞生了GPU。具体区别可以看这里 (opens new window)。
# 网络设施
- WLAN芯片(高通Qualcomm(Atheros)/博通Broadcom/MTK(Ralink+Trendchip/Econet)/Realtek/Marvell)
- 以太网芯片Ethernet(博通Broadcom/Realtek)
- VDSL芯片(博通Broadcom/海思/Realtek)
- PON光网络芯片(博通Broadcom/海思/中兴/Marvell/Realtek)
- 交换器Switch(Realtek)
# 移动通讯
- 基带芯片/调制解调器(高通Qualcomm/联发科MTK/英特尔Intel/博通Broadcom/迈威尔Marvell) — 技术含量非常高, 高通是基带技术的巨头,有大量的基带技术的专利。这一块涉及网络通讯与网络速度的问题。
- 指纹识别(Apple/Synaptics/高通Qualcomm/博通Broadcom/FPC/汇顶科技)
- 触控IC(Synaptics/高通Qualcomm/博通Broadcom)
- NFC(恩智浦NXP/)
###其他场景
- 汽车IC(恩智浦NXP(正被高通收购)/英飞凌/瑞萨电子/意法半导体/德州仪器/博世/安森美半导体)
- 电视芯片(SONY/中兴/联咏)
- 电源管理芯片(德州仪器IT/安森美ON Semi/英飞凌Infineon/Dialog)
# 智能手机芯片Soc
# 苹果A11芯片
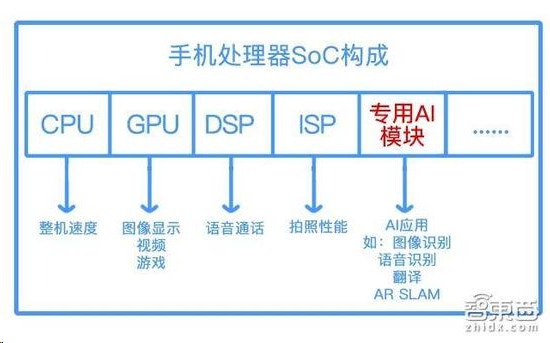 CUP:六个核心
拥有4个高性能核心和2个高能效核心。高低能效两种内核可以根据不同的需要,来达到理想的性能与能效表现。其中高能效内核用于应付密集型的重度任务,提升处理速度保证性能。而高能效内核则应用于日常事务,低能耗运行,从而保证电池续航能力的提升,享受更长的单次充电续航时间。
CUP:六个核心
拥有4个高性能核心和2个高能效核心。高低能效两种内核可以根据不同的需要,来达到理想的性能与能效表现。其中高能效内核用于应付密集型的重度任务,提升处理速度保证性能。而高能效内核则应用于日常事务,低能耗运行,从而保证电池续航能力的提升,享受更长的单次充电续航时间。
 GPU: 自主设计
之前苹果采用一直采用来自Imagination Technologies公司设计的GPU图形处理单元。放弃PowerVR GPU,改用将自主研发GPU图形芯片技术。3个核心。
GPU: 自主设计
之前苹果采用一直采用来自Imagination Technologies公司设计的GPU图形处理单元。放弃PowerVR GPU,改用将自主研发GPU图形芯片技术。3个核心。
存储控制器(存储主控采用NVMe协议) 视频编码器  AI深度学习模块
AI深度学习模块
# AI深度学习IC
# 两大主流架构
- FPGA(赛灵思Xilinx/英特尔Intel)- 场效可编程逻辑闸阵列FPGA运用硬件语言描述电路,根据所需要的逻辑功能对电路进行快速烧录。一个出厂后的成品FPGA的逻辑块和连接可以按照设计者的需要而改变,这就好像一个电路试验板被放在了一个芯片里,所以FPGA可以完成所需要的逻辑功能。FPGA和GPU内都有大量的计算单元,因此它们的计算能力都很强。在进行神经网络运算的时候,两者的速度会比CPU快很多。但是GPU由于架构固定,硬件原生支持的指令也就固定了,而FPGA则是可编程的。其可编程性是关键,因为它让软件与终端应用公司能够提供与其竞争对手不同的解决方案,并且能够灵活地针对自己所用的算法修改电路。
- 图形处理器GPU(英伟达NVIDIA/AMD(ATI)/Imagination/高通Qualcomm/ARM/Vivante)
- ASIC(Application Specific Integrated Circuit)。顾名思义,ASIC就是根据特定的需求而专门设计并制造出的芯片,能够优化芯片架构,针对性的提出神经网络计算处理的指令集,因而在处理特定任务时,其性能、功耗等方面的表现优于 CPU、GPU 和 FPGA;但ASIC算法框架尚未统一,因此并未成为目前主流的解决方案。
# 为深度学习模型设计的架构ASIC/神经网络处理器NPU
- IPU(谷歌为TensorFlow深度学习框架设计)
- 地平线(基于FPGA+ARM架构 http://www.horizon.ai/)
- 深鉴科技(基于FPGA+ARM架构 http://www.deephi.com/zh-cn/)—看好
- 寒武纪(自行提出的架构 http://www.cambricon.com/)—看好
- 耐能Kneron(ARM架构 http://www.kneron.com/)—看好
# FPGA和GPU的性能差异
有三个指标可供对比:峰值性能、平均性能与功耗能效比。 峰值性能:GPU远远高于FPGA* GPU上面成千上万个核心同时跑在GHz的频率上是非常壮观的,最新的GPU峰值性能甚至可以达到10TFlops 以上。GPU的架构经过仔细设计,在电路实现上是基于标准单元库而在关键路径上可以用手工定制电路,甚至在必要的情形下可以让半导体fab依据设计需求微调工艺制程,因此可以让许多core同时跑在非常高的频率上。
相对而言,FPGA首先设计资源受到很大的限制,例如GPU如果想多加几个核心只要增加芯片面积就行,但FPGA一旦型号选定了逻辑资源上限就确定了。而且,FPGA里面的逻辑单元是基于SRAM查找表,其性能会比GPU里面的标准逻辑单元差很多。最后,FPGA的布线资源也受限制,因为有些线必须要绕很远,不像GPU这样走ASIC flow可以随意布线,这也会限制性能。
平均性能:GPU逊于FPGA FPGA可以根据特定的应用去编程硬件,例如如果应用里面的加法运算非常多就可以把大量的逻辑资源去实现加法器,而GPU一旦设计完就不能改动了,所以不能根据应用去调整硬件资源。
目前机器学习大多使用SIMD架构,即只需一条指令可以平行处理大量数据,因此用GPU很适合。但是有些应用是MISD,即单一数据需要用许多条指令平行处理,这种情况下用FPGA做一个MISD的架构就会比GPU有优势。
所以,对于平均性能,看的就是FPGA加速器架构上的优势是否能弥补运行速度上的劣势。如果FPGA上的架构优化可以带来相比GPU架构两到三个数量级的优势,那么FPGA在平均性能上会好于GPU。
功耗能效: FPGA能效比GPU高 功耗方面,虽然GPU的功耗远大于FPGA的功耗,但是如果要比较功耗应该比较在执行效率相同时需要的功耗。如果FPGA的架构优化能做到很好以致于一块FPGA的平均性能能够接近一块GPU,那么FPGA方案的总功耗远小于GPU,散热问题可以减轻。反之,如果需要二十块FPGA才能实现一块GPU的平均性能,那么FPGA在功耗方面并没有优势。
能效比的比较也是类似,能效指的是完成程序执行消耗的能量,而能量消耗等于功耗乘以程序执行的时间。虽然GPU的功耗远大于FPGA的功耗,但是如果FPGA执行相同程序需要的时间比GPU长几十倍,那FPGA在能效比上就没有优势了;反之如果FPGA上实现的硬件架构优化得很适合特定的机器学习应用,执行算法所需的时间仅仅是GPU的几倍或甚至于接近GPU,那么FPGA的能效比就会比GPU强。
# 场景
车联网、高级驾驶辅助上,发现汽车并不好做,厂商对产品准确度、性能要求非常高。最重要的是,因为汽车的研发周期较长,与车企确定合作之后,产品可能四五年之后才会被采用,也就意外着四五年之后才能拿到钱。
安防、家居、手机需要低功耗。
# 通讯组件: 由基带、中频、射频零部件
- 基带/调制解调器IC(高通Qualcomm/联发科MediaTek/博通Broadcom)
- 中频IC(手机中的中频IC一般封装在射频IC中)
- 射频IC(思佳讯Skyworks/威讯Qorvo/博通Broadcom)
# 通讯原理
现在的手机是属于“数码通讯”,也就是我们讲话的声音(连续的模拟讯号),先由手机转换成不连续的0与1两种数码讯号,再经由数码调变转换成电磁波(模拟讯号载着数码讯号),最后从天线传送出去,原理如图所示。
 数码通讯系统的架构如图所示,使用者可能使用智能手机打电话进行语音通信或上网进行资料通信,我们分别说明如下:
数码通讯系统的架构如图所示,使用者可能使用智能手机打电话进行语音通信或上网进行资料通信,我们分别说明如下:
 语音上传(讲电话):声音由麦克风接收以后为低频模拟讯号,经由低频模拟数码转换器(ADC)转换为数码讯号,经由“基带芯片(BB)”进行资料压缩(Encoding)、加循环式重复检查码(CRC)、频道编码(Channel coding)、交错置(Inter- leaving)、加密(Ciphering)、格式化(Formatting),再进行多任务(Multiplexing)、调变(Modulation)等数码讯号处理。
语音上传(讲电话):声音由麦克风接收以后为低频模拟讯号,经由低频模拟数码转换器(ADC)转换为数码讯号,经由“基带芯片(BB)”进行资料压缩(Encoding)、加循环式重复检查码(CRC)、频道编码(Channel coding)、交错置(Inter- leaving)、加密(Ciphering)、格式化(Formatting),再进行多任务(Multiplexing)、调变(Modulation)等数码讯号处理。
接下来经由“中频芯片(IF)”也就是高频数码模拟转换器(DAC)转换为高频模拟讯号(电磁波);
最后再经由“射频芯片(RF)”形成不同时间、频率、波形的电磁波由天线传送出去。
语音下载(听电话):天线将不同时间、频率、波形的电磁波接收进来,经由“射频芯片(RF)”处理后得到高频模拟讯号(电磁波),再经由“中频芯片(IF)”也就是高频模拟数码转换器(ADC)转换为数码讯号。
接下来经由“基带芯片(BB)”进行解调(De-modulation)、解多任务(De-multiplexing)、解格式化(De-formatting)、解密(De-ciphering)、解交错置(De-inter-leaving)、频道解码(Channel decoding)、解循环式重复检查码(CRC)、资料解压缩(Decoding)等数码讯号处理,最后再经由低频数码模拟转换器(DAC)转换为低频模拟讯号(声音)由麦克风播放出来。
资料通信(上网):基本上资料通信不论上传或下载都是数码讯号,所以直接进入基带芯片(BB)处理即可,其他流程与语音通信类似,在此不再重复描述。
# 无线通讯系统架构
主要包括:基带(BB)、中频(IF)、射频(RF)三个部份
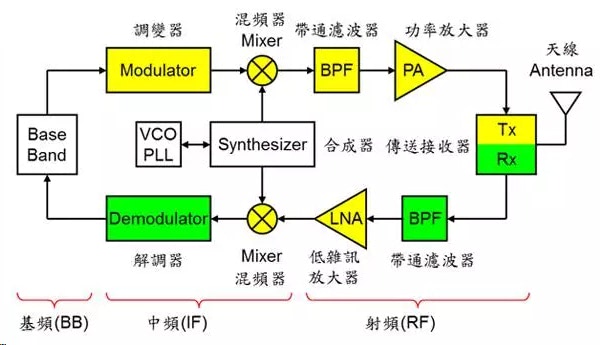 基带芯片/调制解调器(Baseband,BB):属于数码集成电路,用来进行数码讯号的压缩/解压缩、频道编码/解码、交错置/解交错置、加密/解密、格式化/解格式化、多任务/解多任务、调变/解调,以及管理通讯协定、控制输入输出界面等运算工作,著名的移动电话基带芯片供应商包括:高通(Qualcomm)、联发科(MediaTek)、博通(Broadcom)、迈威尔(Marvell)等。
基带芯片/调制解调器(Baseband,BB):属于数码集成电路,用来进行数码讯号的压缩/解压缩、频道编码/解码、交错置/解交错置、加密/解密、格式化/解格式化、多任务/解多任务、调变/解调,以及管理通讯协定、控制输入输出界面等运算工作,著名的移动电话基带芯片供应商包括:高通(Qualcomm)、联发科(MediaTek)、博通(Broadcom)、迈威尔(Marvell)等。
调变器(Modulator):将基带芯片处理的数码讯号转换成高频模拟讯号(电磁波),才能传送很远,想要进一步了解通讯原理的人可以参考这里。
混频器(Mixer):主要负责频率转换的工作,将调变后的高频模拟讯号(电磁波)转换成所需要的频率,来配合不同通讯系统的频率范围(无线频谱)使用。
合成器(Synthesizer):提供无线通讯电磁波与射频集成电路(RF IC)所需要的工作频率,通常经由“相位锁定回路(PLL:Phase Locked Loop)”与“电压控制振荡器(VCO:Voltage Controlled Oscillator)”来提供精准的工作频率。
带通滤波器(Band Pass Filter,BPF):只让特定频率范围(频带)的高频模拟讯号(电磁波)通过,将不需要的频率范围滤除,得到我们需要的频率范围(频带)。
功率放大器(Power Amplifier,PA):高频模拟讯号(电磁波)传送出去之前,必须先经由功率放大器(PA)放大,增强讯号才能传送到够远的地方。
传送接收器(Transceiver):负责传送(Tx:Transmitter)高频模拟讯号(电磁波)到天线,或是由天线接收(Rx:Receiver)高频模拟讯号(电磁波)进来。
低噪声放大器(Low Noise Amplifier,LNA):接收讯号时使用,天线接收进来的高频模拟讯号(电磁波)很微弱,必须先经由低噪声放大器(LNA)放大讯号,才能进行处理。
解调器(Demodulator):接收讯号时使用,将高频模拟讯号(电磁波)转换成数码讯号,再传送到基带芯片(BB)进行数码讯号处理工作。
所以手机上传(讲电话)的原理是:先由基带芯片(BB)处理数码语音讯号,再经由调变器(Modulator)转换成高频模拟讯号,由混频器(Mixer)转换成所需要的频率,由带通滤波器(BPF)得到特定频率范围(频带)的高频模拟讯号(电磁波),由功率放大器(PA)增强讯号,最后由传送接收器(Tx)传送到天线输出。
相反的,手机下载(听电话)的原理是:先由天线传送过来高频模拟讯号(电磁波),由传送接收器(Rx)接收进来,再经由带通滤波器(BPF)得到特定频率范围(频带)的高频模拟讯号,由低噪声放大器(LNA)将微弱的讯号放大,由混频器(Mixer)转换成所需要的频率,由解调器(Demodulator)转换成数码语音讯号,最后由基带芯片(BB)处理数码语音讯号。
# 四、存储器
# 产品
- DRAM
- LPDDR(也称MDDR),移动设备使用的DRAM;
- DDR,PC或服务器使用的DRAM;
- 三星、英特尔等技术更为领先的玩家,则在研究替代 DRAM 的新型内存
- MRAM,磁阻式随机存取内存(Magnetoresistive Random Access Memory),主要玩家是三星和台积电,这种内存使用寿命更长,芯片面积更小,反应速度更快,因此被业内视为最有可能取代 DRAM 的技术。
- RRAM,可变电阻式内存(Resistive random-access memory),英特尔和镁光共同研发的「3D Xpoint」就属于这种,写入速度比 NAND 闪存快一万倍,比 DRAM 快 10 倍
# (1)DRAM
# 颗粒厂商(上游产业)
 韩国和美国几乎已经垄断了全球的存储器市场。
韩国和美国几乎已经垄断了全球的存储器市场。
- 三星电子(韩国)
- SK 海力士(韩国)
- 英特尔(美国)
- 镁光科技(美国)
- 东芝半导体(贝恩资本领衔的财团拿下,其背后是苹果、戴尔、SK 海力士等公司,基本上也都是美国和韩国的玩家)
# DRAM模组厂商

- 金士顿Kingston,占有大部分的市场70%左右(美国,华人创立);
- 美国世迈SMART Modular(美国)
- 记忆科技RAMAXEL(中国深圳)
- 威刚科技Adata(台湾)
- 金泰克Tigo/kimtigo(中国深圳)
- 创见Transcend(台湾)
# (2)NAND闪存
NAND闪存分为SLC、eMLC、MLC和TLC。
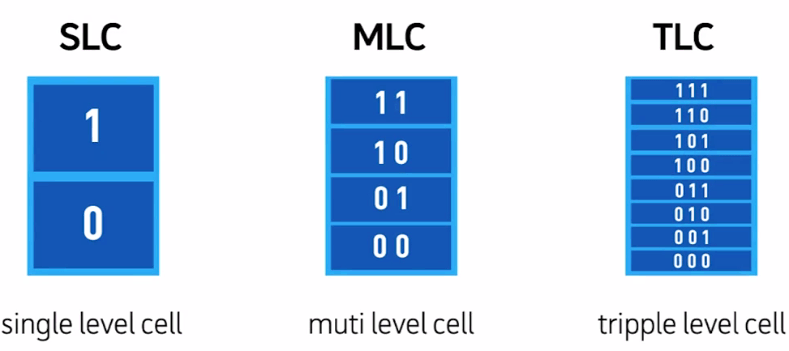

SLC、eMLC、MLC、TLC的读写速度依次从快至慢,使用寿命依次从长至短,成本依次从高至低。
SLC SLC传统上,每个储存单元内储存1个信息位,称为单阶储存单元(Single-Level Cell,SLC)。SLC闪存的优点是传输速度更快,功率消耗更低和储存单元的寿命更长。然而,由于成本较高,大多数用在企业上,很少有消费型SLC储存装置拿来贩卖。
eMLC eMLC指的是企业级MLC(Enterprise Multi Level Cell),它是MLC闪存,但针对企业领域进行了优化,具有更好的性能和耐久性。eMLC的性能比不上SLC,但eMLC的成本较低。
MLC MLC多阶储存单元(Multi-Level Cell,MLC)可以在每个储存单元内储存2个以上的信息位。与SLC相比,MLC成本较低,其传输速度较慢,功率消耗较高和储存单元的寿命较低,因此MLC闪存技术会用在标准型的记忆卡,也用在最常见的消费型固态硬盘和随身碟上。
TLC TLC三阶储存单元(Triple-Level Cell, TLC),这种架构的原理与MLC类似,但可以在每个储存单元内储存3个信息位。TLC的写入速度比SLC和MLC慢,寿命也比SLC和MLC短,大约1000次。现在,厂商已不使用TLC这个名字,而是称其为3-bit MLC。
SLC、MLC和TLC的发展历程固态硬盘的主流从SLC芯片转到MLC芯片,促成了2011年的大降价,固态硬盘因此普及。由于因为SLC的速度较快但成本过高,用于服务器的企业级SSD都改用了MLC。
# 固态硬盘SSD
SSD 主要作用是取代 PC/服务器 上的 HDD 硬盘,它需要:
- 超大容量(百GB~TB级别)
- 极高的并行性以提高性能
- 对功耗,体积等要求并不敏感
- 兼容已有接口技术 (SATA,PCI-E 等)
一个SSD,为了达到高并行高性能的要求,有多个Flash 芯片,Flash与主控不一起封装,这样就可以在每个芯片上进行相互独立的读写操作,以并行性来提高硬盘吞吐量,还可以增加冗余备份。SATA 3.0接口最高峰值数据500MB/s。PCI-E支持NVMe接口标准,在所有协议中最快。M.2 接口,通常在笔记本使用,现在大部分走SATA协议通道。

# 移动设备存储器接口协议
eMMC、UFS、NVMe接口协议主要都是针对移动设备发明的,即嵌入式存储,它们需要:
- 适当的容量
- 适当的性能
- 对功耗 ,体积的要求极其敏感
- 仅需遵循一定的接口标准(eMMC、UFS、NVMe) 为了节省空间和功耗,通常只有一片密度较高的 Flash 芯片,同时会将主控一起封装节省空间。NVMe是苹果采用的解决方案。苹果压根就没看上UFS 2.0标准,而是借鉴MacBook固态存储方案,非常前瞻性地引入NVMe协议,并支持TLC/SLC混合缓存加速。相比传统SCSI接口协议,NVMe具有高效率、低负载的特性,表现出更高性能和更低延迟。
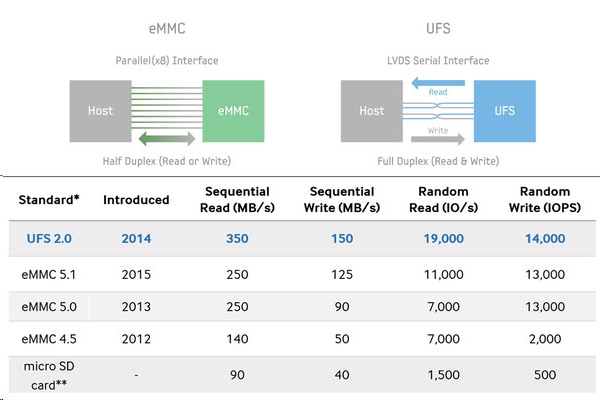
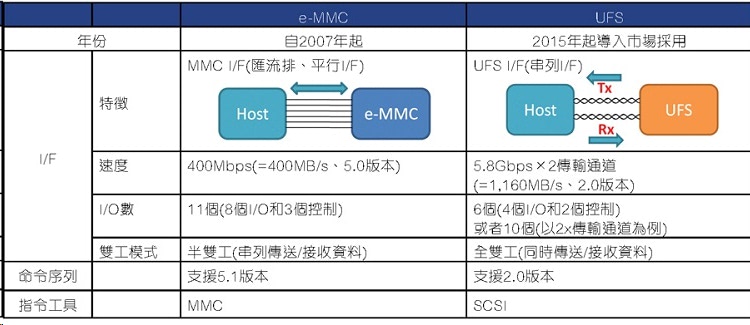
# eMCP
将RAM与ROM封装在一起,可以减少主晶片运算的负担,并且管理更大容量的快闪记忆体,有助于提升性能,主要是针对移动设备发明的。
# 颗粒厂商(上游产业)
- 三星电子(韩国)
- SK 海力士(韩国)
- 英特尔(美国)
- 镁光科技(美国)
- 东芝半导体(贝恩资本领衔的财团拿下,其背后是苹果、戴尔、SK 海力士等公司,基本上也都是美国和韩国的玩家)
- 闪迪SanDisk/西部数码WDC(美国,闪迪被西部数码WDC收购)

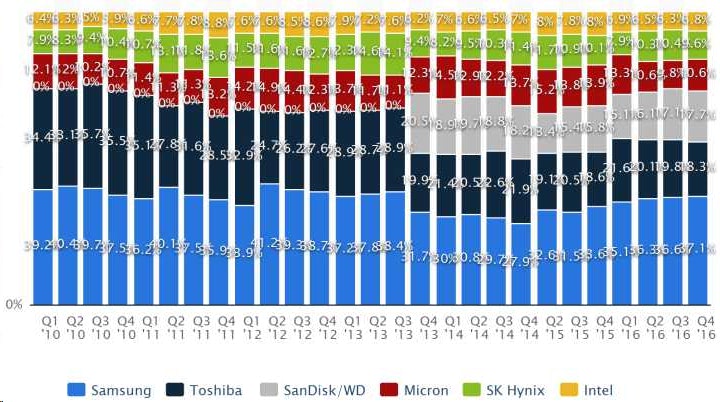
# SSD控制器
其中在主控芯片解决方案的策略上,Samsung完全采用自家芯片;Sandisk、Intel、 Toshiba、SK Hynix、Micron则是采外包加自制的混合策略;至于光宝科技Liteon、Kingston则是完全采用外包的方式;
外包主要是美满Marvell、慧荣、群联;



# SSD整合/消费品牌
- 三星(韩国)
- 西部数码/闪迪(美国)
- 光宝(台湾,浦科特Plextor是光宝的子品牌)
- 金士顿(美国)
- 英特尔(美国)
- 东芝(饥饿鲨OCZ是东芝的子品牌)
- 美光(美国)

# 嵌入式提供商
- 三星
- 东芝
- 西数/闪迪
- 美光
- 海力士
- 金士顿
# 五、可编程逻辑器件PLD
# 产品
SPLD - 1000标准门。
FPGA - 提供了最高的逻辑密度、最丰富的特性和最高的性能,,可提供八百万“系统门”(相对逻辑密度)
CPLD - CPLD提供的逻辑资源少得多 -- 最高约1万“系统门”。但是,CPLD提供了非常好的可预测性,因此对于关键的控制应用非常理想。
# 著名厂商
- 赛思灵Xilinx(占大部分市场)
- 萊迪思Lattice
# 六、模拟IC
# 产品
- 第一类是通用型电路,如运算放大器、相乘器、锁相环路、有源滤波器和数-模与模-数变换等;
- 第二类是专用型电路,如音响系统、电视接收机、录像机等专用的集成电路系列;
- 第三类是单片集成系统,如单片发射机、单片接收机等。
# 厂商
- 德州仪器Ti
- 意法半导体ST
- 英飞凌Infineon
- 思佳讯Skyworks
# 七、传感器
# 产品
- 微机电传感器
- 加速度计
- 陀螺仪
- 数字罗盘
- 惯性模块
- 压力传感器
- 湿度传感器
- 麦克风
- 智能传感器
- Sensor Hub
- 温度传感器
- 触摸传感器
- CMOS图像传感器
# 厂商
- 博世Bosch
- 意法半导体ST
- 德州仪器Ti
- 博通Broadcom(前身安华高Avago)
- 楼氏电子Knowles Electroincs
- 索尼sony(专攻影像传感器,全球最大的 CMOS 供应商,占全球份额的 40%)
# CMOS图像传感器厂商
- 索尼sony(全球最大的 CMOS 供应商包括相机与手机,占全球份额的 40%)
- 三星Samsung(全球第二大手机CMOS供应商,占有全球份额 20%)
- 豪威OV(中低端手机CMOS图像传感器,中信资本、北京清芯华创投资管理有限公司和金石投资有限公司组成的财团购买)
- 佳能(在数码相机领域旗舰级别CMOS,现在也对外供应了)
- 意法半导体ST(是进入手机摄像头领域较早的公司之一,得益于在半导体行业中的雄厚实力,尤其是丰富的 CMOS 芯片设计制造经验和纵向完整的供应链,ST一直是这一市场的有力竞争者。目前是全球前十大CMOS图像传感器供应商之一,也是苹果CMOS供应商。)
# 八、总结
- 无人驾驶/服务器/玩具/智能硬件/智能手机,因为深度学习计算的需求,导致 GUP/FPGA/深度学习芯片的需求增长。看好英伟达/AMD(与特斯拉合作)/赛灵思Xilinx/恩智浦NXP;
- 无人驾驶/图像处理等场景 更多需要高性能,更多会选择GUP/深度学习芯片;
- 国内IC企业,看好寒武纪Cambricon(中科院)/耐能Kneron/深鉴科技(清华)/海思/清华紫光;